芯片bga封装的优点和缺点有哪些?

想要弄清楚芯片bga封装的优点和缺点,首先,我们要了解决一下芯片封装技术的发展历程。
芯片的封装技术已经历了好几代的受迁UDIP、QFPI PGA、BGA到到CSP再到MCM 技术指标一代比一代先进,包括芯片面积与封装面积之比越来越接近于1,适用频丰越来越高,耐温性能越来越好,引脚数增多,引脚间距减小、重量减小,可靠性提高,使用更加方便等等。
从20世纪70年代流行的是双列直播封装,简称DIP。到80年代出现了芯片载体封装,其中有陶瓷无引线芯片载体LCCC、塑料有引线芯片载体PLCC、小尺寸封装SOP、塑料四边引出扁平封装 PQFP等。
直到20世纪90年代随着技术的进步,芯片巢成度不断提高。为满足发展的需要,在原有芯片封装品种基础上,又增添了新的品种——球栅阵列封装,简称BGA封装(Ball Grid Array Package)。

(一)芯片BAG封装的优点:
(1)BGA封装除了芯片本身,一些互联线,很薄的基片,以及塑封盖,其他什么也没有了,裸露在外部的元件很少。没有很大的引脚,没有引出框。整个芯片在PCB上的高度可以做到1.2毫米,这是BGA封装的最大优点之一。
(2)BGA封装的引脚在底部看起来很酷排列整齐,这种方式有个非常大的优点是利于BGA芯片的返修,因为根据其对齐方式很容找到损坏位置来进行拆除。
(3)信号从芯片出发,经过连接线矩阵,然后到你的PCB,再通过电源/地引脚返回芯片构成一个总的环路。外围东西少,尺寸小意味着整个环路小。在相等引脚数目的条件下,BGA封装环路的大小通常是QFP或者SOIC的1/2到1/3。小的环路意味着小的辐射噪声,管脚之间的串扰也变小。
(4)BGA封装还可以高效地设计出电源和地引脚的分布情况,因为地弹效应的存在也使得电源和地引脚数量不断地减少。
(5)BGA封装很牢靠,同20mil间距的QFP相比,BGA没有可以弯曲和折断的引脚。它像砖头一样牢靠,一般如果要拆除BGA封装的话必须使用BGA返修台高温进行拆除才能够完成。
(6)BGA封装可以把很多的电源和地引脚放在中间,I/O口的引线放在外围。这仅仅是一种方法,可以用来在BGA基片上预先布线,避免I/O口走线混乱。
(7)高级BGA封装,可以把所有的引脚都正好放置在芯片下面,不会超过芯片的封装,这对微型化很好。
(8)BGA封装还有一个比较大的优势是焊盘相对来于大一些,在操作返修的时候易于操作。相比于倒晶封装方式要大很多,倒晶封装技术需要焊盘直接放置在硅片上,焊盘需要更小的尺寸,这可能会带来一些问题和制造上的麻烦。倒晶封装技术是一定程度上是不可见的神秘的,其实是名不符实。可以通过BGA的流程来解决掉这个问题。
(9)不需要更高级的PCB工艺。它不像C4和直接倒晶封装的方式那样需要考虑芯片和PCB尺寸的匹配热量传播效率来防止硅片损坏。BGA封装连接线矩阵有足够的机制来保证硅片上热量的压力。没有不匹配和困难。
(10)一个本身就很小的封装,有很好的散热属性。硅片贴在上面的话,大多数热量可以向下传播到BGA的球阵列上如果硅片是贴在底面的话,那么硅片的背部是和封装的顶部相连接,这是很合理的散热方法。
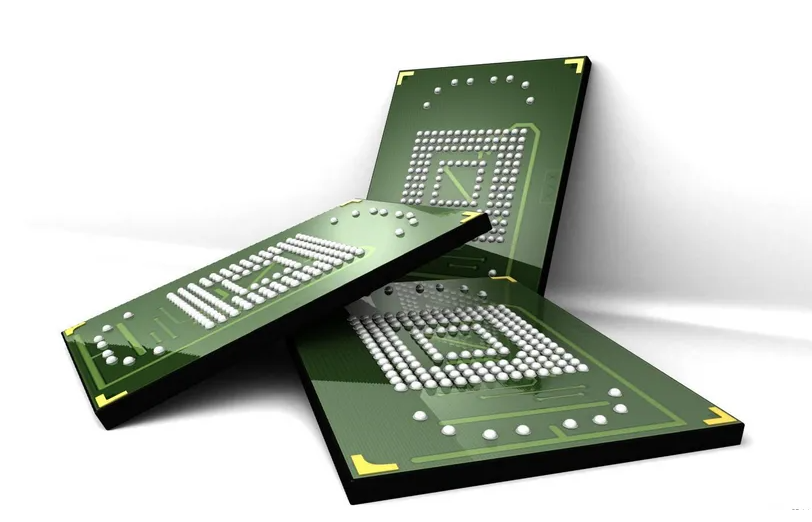
(二)芯片BAG封装的缺点:
(1)BGA焊接后质量检查和维修比较困难,必须使用X-Ray透视检测,才能确保焊接连接的电器性能。无法通过肉眼与AOI来判定检测质量。
(2)BGA引脚在本体的底部,易引起焊接阴影效应,因此对焊接温度曲线要求较高。必须要实时监测焊接实际温度。
(3)BGA引脚个别焊点焊接不良,必须把整个BGA取下来重新植球,再进行第二次贴片焊接。影响直通率及电器性能。
(4)BGA封装很牢靠,同20mil间距的QFP相比,BGA没有可以弯曲和折断的引脚。焊接牢靠,一般如果要拆除BGA封装的话必须使用BGA返修台高温进行拆除才能够完成。
以上内容是由诺芯盛科技为您分享的芯片BGA封装的优点和缺点相关内容,希望对您有所帮助,了解更多关于芯片知识,欢迎访问



